半導体製造プロセス、原理を完全解説
2026-04-07

半導体製造プロセスにはどのようなステップがあるのでしょうか?現代の電子機器に欠かせないチップはどのように作られているのでしょうか?半導体の秘密を理解するには、まず半導体とは何か、そしてその原理から話を始める必要があります。本稿では、半導体製造プロセスの順序、産業チェーンと重要なパッケージング材料について紹介し、よくある質問にもお答えします。
半導体とは?至るところで使われている半導体は、こんな材料で出来ている
半導体は現代テクノロジーの基盤です。目に見えず触れることもできませんが、日常生活におけるあらゆるスマートな応用技術を陰ながら支えています。スマートフォン、パソコンから自動車や医療機器に至るまで、ほとんどすべての電子製品の動作は半導体なしには成り立ちません。この重要な技術を理解するためには、まずその定義、原理、そして材料特性からお話ししなければなりません。では、この世界を変えた材料の秘密を解き明かしていきましょう。
(1)半導体とは?ウエハ、チップ、半導体デバイスとの違いは?
半導体が「半導」体と呼ばれるのは、その電気伝導性が「導体」と「絶縁体」の中間に位置しており、特定の条件下で電流の通過を制御できるためです。まさにこの特性を備えていることから、この種の材料は複雑な導電性の変化を伴う構造物の製造に用いられ、複雑な信号や命令の伝送と処理を可能にしたために、一躍、現代の電子製品の中核を担う存在となりました。しかし、半導体材料だけではそのまま応用することはできず、一連の加工を経て初めて使用可能となるのです。次に示すのは、半導体材料がさまざまな加工を経てつくられた製品です。
- ウエハ(Wafer):半導体材料を切断、研磨して形成された円形片であり、その後の製造の基板として使用されます。
- チップ(Chip):ウエハから切り出された単一の小片で、回路設計とパッケージングを経て、実際に使用されるプロセッサやメモリとなります。
- 半導体デバイス(Device/Component):チップの機能を利用して製造される各種応用デバイスで、ダイオードやトランジスタ、集積回路はその一例です。
これらの関係は、半導体材料 → ウエハ → チップ → 半導体デバイス、といった形で簡略化して理解できます。
チップおよび半導体デバイスの用途は極めて広く、スマートフォン、コンピュータ、家電製品から、自動車、医療機器、通信ネットワークに至るまで、すべて半導体によって駆動・制御されているのです。
(2)半導体材料:「半導電」という性質を可能にする鍵
では、半導体はなぜこのような独特の半導電性を持つことができるのでしょうか。半導体の特殊な性質は、材料構造そのものが程よい「バンドギャップ」を有していることによります。「バンドギャップ」とは、固体中で電子が充満しているエネルギー層である「価電子帯」と、電子が自由に移動して電気を通すことができるエネルギー層である「伝導帯」との隔たりを指し、バンドギャップが小さいほど、導電性は高くなります。半導体のバンドギャップはおよそ 1~3eV(導体のバンドギャップはほぼ 0、絶縁体のバンドギャップは通常 9eV 以上)で、加熱や光照射、電場刺激を受けると電子がバンドギャップを越えて伝導帯へ移ることができるため、「半導電」の振る舞いができるのです。
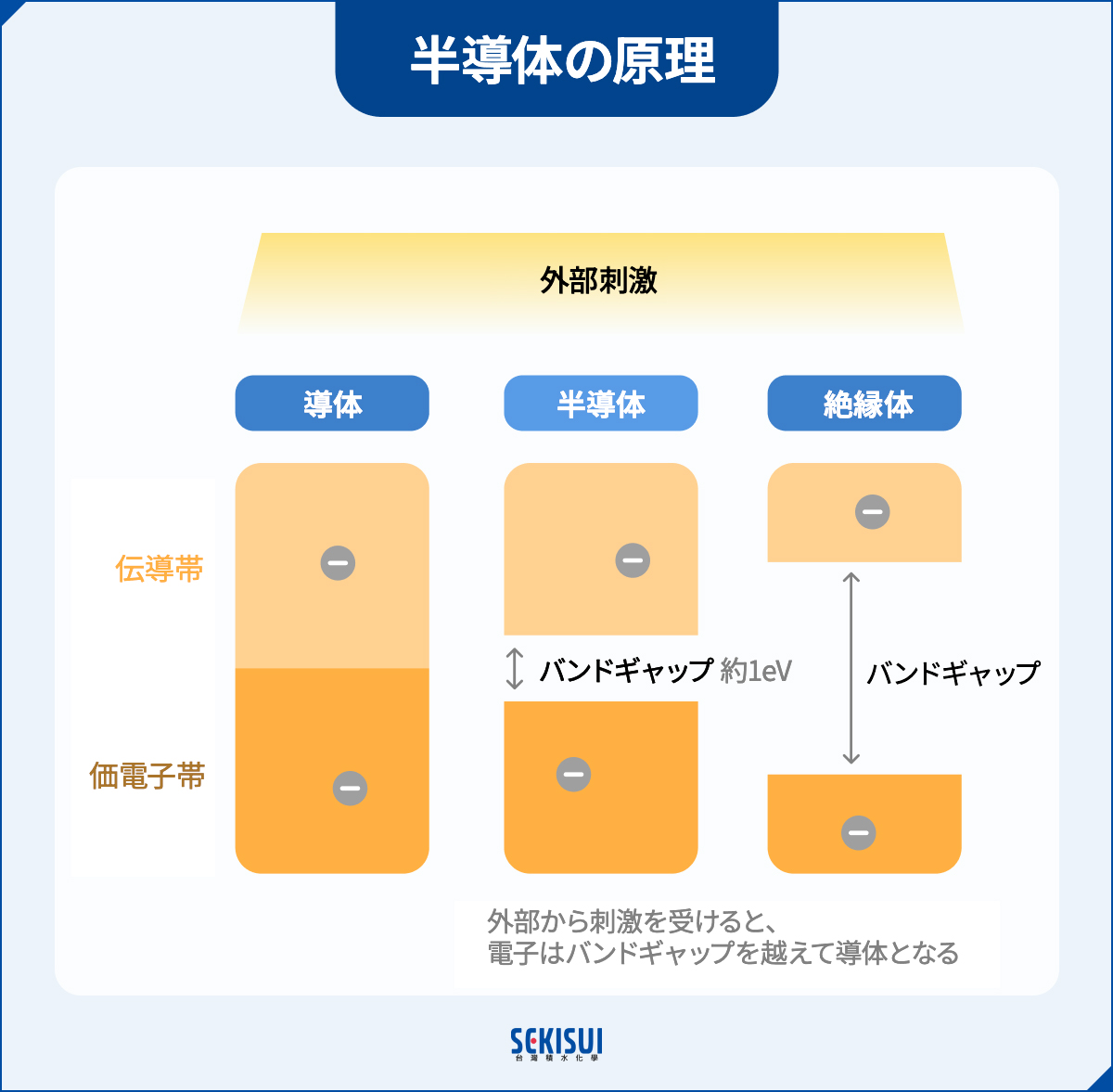
半導体の材料として最も広く使用されているのはシリコン(Silicon)で、自然界に豊富に存在し、現在ではその加工技術も十分に確立されています。このほかにも、ゲルマニウム(Germanium)、ガリウムヒ素(GaAs)、窒化ガリウム(GaN)などを材料とする半導体は、高周波、高出力あるいはオプトロニクス分野における応用で、より優れた性能を発揮しています。
注目すべき点としては、高温や光照射といった電子を伝導帯に励起する方法に加え、現在ではドーピング(Doping)によって導電性を変化させる手法もあるということです。例えば、純シリコン自体の導電性はそれほど高くありませんが、リンやホウ素などの元素を添加することで電子や正孔を調整し、N型あるいはP型の半導体を形成できます。このようにすることで、「部分導電」といった効果が得られるだけでなく、電流の流れを精密に制御することも可能となるため、現代の電子機器で最も広く使われている技術となっています。
- N型半導体:シリコン結晶に五価元素(リンやヒ素など)をドーピングします。これらの原子は5個の価電子を持ち、シリコン(4個の価電子)と結合すると、結合に関与しない自由電子が1個余ります。この余分な電子が結晶中を自由に移動できるため、導電性が向上します。
- P型半導体:N型とは対照的に、シリコン結晶に三価元素(ホウ素 B、アルミニウム Alなど)をドーピングすると、各原子は価電子を3個しか持たないため、シリコンと結合する際には電子が1個不足して電子の欠落した空白(「正孔」)が生じます。正孔が近くの電子を引き寄せて空白を埋めるため、その位置が電場とは反対方向へ移動することで、導電効果が生まれます。
半導体デバイス製造の全貌を暴く――半導体製造の8ステップ+産業チェーンを知る
これほど「神秘的」な半導体がいったいどのように製造されているのか、きっと気になっていることでしょう。ここからは、半導体産業チェーンの運営モデルを包括的にご紹介し、ウエハ製造の8つの主要ステップについて解説します。シリコンウエハがクリーンルームの中でどのようにして知能を与えられ、最終的にテクノロジーを動かす心臓へと変わるのかを見ていきましょう。詳細な説明と図解を通じて、半導体が構想から完成品に至るまでの製造プロセスをより明確に理解できるようになります。
(1)「ひらめき」から「部品」へ:半導体産業チェーンの紹介
構造設計から実際の製造、材料からデバイスに至るまで、各段階で大量の人材と資源を投入してはじめて、小さくても高性能な半導体チップの生産が可能となり、その後さまざまな分野のメーカーによって活用されます。半導体の産業チェーン全体は、大きく3つに分けられます。
- 上流(設計、材料):IC設計会社が回路アーキテクチャの設計を担い、材料メーカーがシリコンウエハやフォトマスク、化学薬品を供給して、製造に必要な基盤を提供します。
- 中流(製造):ファウンドリはフォトリソグラフィー、成膜、エッチングなどの複雑な工程を通じて、回路設計をチップへと精密に変換します。
- 下流(パッケージング、テスト):チップ完成後は、保護のためのパッケージングと電気的テストを経て、性能と品質を確保してから、システムメーカーやブランドメーカーへ出荷されます。
産業チェーンの全プロセスを経たチップは、その使用分野や用途に応じて、さまざまな半導体デバイスとして構成され、スマートフォン・自動車・家電・医療機器などに幅広く活用され、現代生活のあらゆる場面を支えています。
(2)ウエハ製造プロセスの完全解説 ― 半導体製造プロセスの順序と原理に対する理解を深める
1. 精製と結晶成長
天然の石英砂を化学処理し、高純度の多結晶シリコンに変換して加熱・溶融した後に、単結晶の種結晶を接触させて均一に結晶を引き上げる「引き上げ(CZ法)」技術によって、単結晶シリコンインゴットをつくりあげます。高純度と高い結晶性はチップ性能を確保するための重要な鍵であり、わずかな不純物であっても後工程における欠陥原因となる可能性があるため、特定の環境下で専門設備を用いる専門性の高いメーカーに任せる必要があります。このステップは通常、材料メーカーが担当し、ウエハ製造プロセスの起点となります。
2. スライスと研磨
単結晶シリコンインゴットは薄片状に切断され、精密な研磨と洗浄を経て「ベアウエハ」となります。ベアウエハは、清潔で平坦な白紙のようなもので、後工程ではこの表面に回路パターンを形成することができます。表面が十分に滑らかでなければ、この後のフォトリソグラフィーやエッチングは正確に行えません。
3. 酸化と薄膜堆積
続いて本格的にウエハ加工のステップに進みます。まず、シリコンウエハ表面に極めて薄い二酸化ケイ素膜を形成します。この過程を酸化といいます。酸化層は絶縁と保護の役割を持ち、シリコン結晶が後から追加される金属導線と接触しないようにして、電気的干渉と不純物の拡散を防止します。その後、薄膜堆積技術によって、ウエハ表面に導電性金属層や誘電体層などの複数の機能性薄膜を被覆します。これらの構造は、この後のフォトリソグラフィーやエッチングのための基材として機能し、チップ内の各素子の電気特性構造の基盤を形成します。
4. フォトリソグラフィー
フォトリソグラフィーでは、フォトレジストの塗布と露光・現像により、まるで「写真の現像」のように、光を照射することで回路設計のパターンをウエハ上に転写します。線幅が小さいほどチップに搭載できるトランジスタの数が増え、計算能力もより高まるため、最も重要なステップの一つです。
5. エッチング
エッチングとは、化学薬液やプラズマエッチングによって、フォトリソグラフィー後の不要な部分を除去し、必要な配線や構造のみを残すステップです。この段階で、ようやく回路がウエハ表面に実際に刻み込まれ、徐々にトランジスタの原型が形成されていきます。エッチング完了後には、後工程に影響を与えないよう、フォトレジストの剥離が行なわれます。最後に、ウエハを洗浄して、残留したフォトレジストの破片やエッチングの副生成物を完全に除去し、表面を清浄に保つことで、スムーズに次のステップへ進むことができます。
6. ドーピング
ウエハに微量元素(ホウ素やリンなど)を導入して局所領域の導電性を調整し、P型とN型半導体を形成します。これにより、トランジスタをスイッチのようにして電流の流れの制御や微調整ができるようになります。
7. 金属配線
ウエハ表面に金属導線を配置し、無数のトランジスタを接続することで、完全な回路ネットワークが構築されます。都市の道路網のように、金属配線は信号を高速に伝送し、最終的に出来上がったチップの正常な動作を確保します。
ウエハ加工のステップは、回路が張り巡らされたウエハを完成させるために、数十回から場合によっては百回以上も繰り返し行われますが、珍しいことではありません。
8. ウエハ後工程
ウエハ後工程の主な目的は、ウエハをより薄く軽量にし、導電性を向上させるとともに、この後のパッケージングに備えることです。このステップでは、まず裏面の研磨やポリッシングによる薄化処理や貫通孔加工、異種集積などを行います。加工時の安定性を保つため、一時的なボンディングやデボンディング(Debonding)技術を用いて、ウエハをいったんキャリア基板に固定して処理を行い、完了後に剥離します。これらの工程が終わると、ウエハは次の工程で利用できるよう、個々のチップに切断されます。
最後に、切り出されたチップはパッケージングとテスト段階へと進みます。パッケージングの目的は、外力、湿気、静電気や汚染による損傷からチップを保護するとともに、電気的接続と効率的な放熱経路を確立し、実際の動作時にチップが安定して高効率で動作できるようにすることです。パッケージング材料はここで重要な役割を果たして、チップを保護し、放熱を強化するだけでなく、チップと回路基板の間に安定した接続を確立し、実際の長時間使用環境における安定した動作を確保します。最後に、電気的テストと機能テストで性能と信頼性を確認し、不良品を選別します。
こうした一連の後工程を経て、ようやく半導体デバイスは完成し、様々な電子製品で使用できるようになります。
(3)半導体製造プロセスの各ステップをわかりやすく示したフロー図

ここまでの煩雑で精緻な製造プロセスお読みになり、半導体製造プロセスの難しさをご理解いただけたことと思います。材料の純度、環境管理、荷重制御など、いずれの面においても、少しでもミスがあれば歩留まりに深刻な影響を与えてしまいます。製造プロセスの最終関門であるパッケージング工程では、製品の完成を目の前にしてこれまで投入したコストを無駄にしてしまわないためにも、より慎重な対応が求められます。
より精密な半導体パッケージング工程を実現するためには、高品質なパッケージング材料が欠かせません。例えば、粘着力が高く、剥離しやすく、糊残りのないテープや、チップ表面を損傷から保護する離型フィルム、導電性や熱伝導性を確保する粒子フィラーなどは、異なる側面から工程の進行を助け、完成品の性能をさらに向上させることができます。
半導体製造プロセスはなぜこれほど複雑なのか?半導体製造プロセスのよくある質問に回答
半導体製造プロセスについて、ほかにもわからない点がありますか?ここでは、半導体製造プロセスのステップの複雑さ、パッケージング材料の役割、パッケージングとテスト段階の重要性に関する3つのよくある質問をまとめ、順に解説します。
Q1:なぜ半導体の製造プロセスには、こんなに多くのステップが必要なのですか?
半導体製造プロセスは極めて精密なエンジニアリングで、わずか数十ミリメートルのウエハ1枚に、数十億個のトランジスタと複雑な回路構造を集積する必要があるためです。シリコン原料の精製から、フォトリソグラフィー、エッチング、ドーピング、金属配線、そしてパッケージング、テストに至るまで、各ステップはクリーンルームにおいてナノレベルの精度で完了しなければならず、そうして初めて性能と歩留まりを確保できるのです。
Q2:半導体パッケージング材料にはどのような役割がありますか?
パッケージング材料は、チップと外界との間にある保護層であるとともに橋梁(ブリッジ)としての役割を担っており、それと同時に機械的保護、熱伝導・放熱、電気的接続という3つの主要機能を果たしています。積水化学の各種パッケージング材料を例に挙げると、離型フィルムはチップ表面の保護や緩衝の機能を持ち、金属めっき系微粒子は導電性や熱伝導性の調整に使用され、ビルドアップフィルムは基板とパッケージング層間絶縁材料とすることで、パッケージングによる損失を低減します。
Q3:パッケージングとテストはなぜそんなに重要なのですか?
パッケージングとテストは半導体製造プロセスの最終段階であり、製品を市場に投入できるかどうかの鍵を握ります。パッケージングはチップを外部の汚染や機械的損傷から保護するだけでなく、電気信号を外部回路へ正確に伝達する役割も担うため、設計不良による放熱不足や電気特性の不安定化といった問題を引き起こす可能性があります。
テスト段階では、各チップの機能、周波数、消費電力や安定性を検査し、設計仕様や市場基準に適合していることを確認します。厳しいテストに合格したチップのみが電子製品に組み込まれて動作し、最終的に販売可能な半導体デバイスとなります。
半導体パッケージングプロセス材料の第1候補サプライヤー―SEKISUI
世界的な高分子材料と技術のリーディングブランドとして、SEKISUI 積水化学グループは、確かな材料研究開発力と量産経験を強みに、世界中のウエハやパッケージングメーカーのプロセス効率と信頼性の向上を支援し続けています。当社は、ウエハのダイシング、パッケージング、熱圧着や導電用途に向けて、多様な高性能パッケージング材料を展開し、先進パッケージングと多層基板プロセスのニーズに応えています。当社の主力製品は以下の通りです。
- UV易剥離テープ、パッケージング保護テープ:ウエハのダイシングとパッケージング工程に適用可能で、チップを確実に固定し、センシティブ領域を保護し、機械的損傷や汚染を防止します。
- 熱プレス工程用離型フィルム:熱圧と高温パッケージングプロセスにおいて表面保護と緩衝の役割を果たし、チップの傷や汚染を防止し、安定した歩留まりを確保します。
- Micropearl™ プラスチック微粒子、金属めっき系微粒子:パッケージングの隙間を精確に制御し、導電性と熱伝導性を調整できるほか、軽量フィラーとしても使用可能で、チップの長期安定動作を確保します。
- ビルドアップフィルム(Build-up Film):基板とパッケージング層間に使用され、ずば抜けた絶縁性を有し、信号損失を低減できます。微細配線や高絶縁信頼性が求められる高性能基板製造などの用途に適しています。
- 高粘度インクジェット用インク:擁壁材(DAM Materials)、パターン形成、保護層塗布に適しており、スマートフォンや基板パッケージングなどの分野で広く使用されています。

/SELFA.png)
_熱硬化型層間絶縁フィルム_png_w500px_h333px.png)
_ミクロパール™_png_w500px_h333px.png)

_熱プレス工程用離型フィルム_png_w500px_h500px.png)
