_熱硬化型層間絶縁フィルム_png_w500px_h333px.png)
熱硬化型層間絶縁フィルム
電子デバイスの微細配線化・高速通信化に寄与するビルドアップフィルム
- エレクトロニクス
ビルドアップフィルムとは
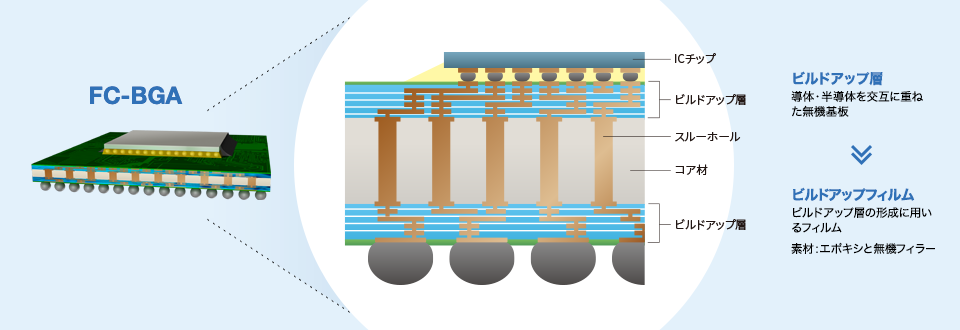
ビルドアップフィルムは、最先端ICパッケージ基板における微細配線層の形成に用いられる層間絶縁材料です。電子デバイスの高速化に伴い、ICパッケージ基板も速度向上や高性能化に対応する為に、高密度化が進み、微細ビア形成性や低誘電特性に加え、加工時や実装時の反りを抑える寸法安定性も重要視されています。これらの最先端ICパッケージ基板はAI、サーバー、ネットワーク機器など多様な分野で採用が進んでおり、ビルドアップフィルムは高性能・高信頼な電子デバイスの実現を支える重要な材料になっています。
特長
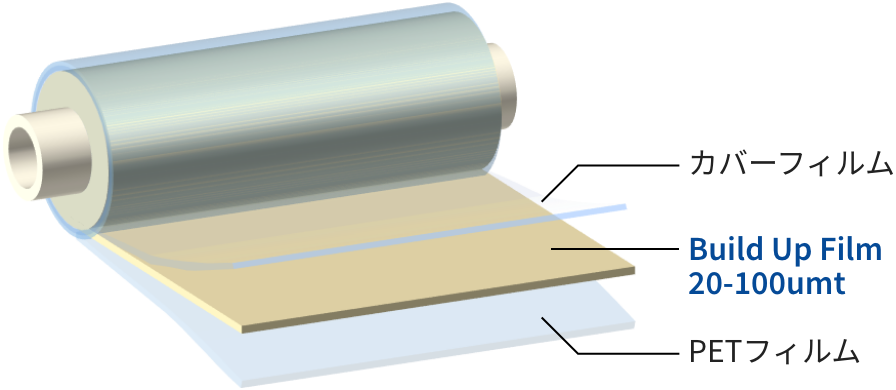
積水化学のビルドアップフィルムは、優れた伝送特性と寸法安定性を兼ね備え、高多層・大サイズのハイエンドICパッケージ基板(FC-BGA)で多数の採用実績があります。
低誘電、ICパッケージ基板の低反りを実現する特性により、パッケージ設計の自由度を高め、次世代デバイスの高性能化と高信頼化に貢献しています。
- 基板反りの
抑制 - 低伝送ロス
- FLSの実現
- 良好な
埋込性
積水の強み
積水化学のビルドアップフィルムは、独自の配合・塗工技術により、低誘電正接(低Df)、均一なデスミア後の表面粗さ、高いクラック耐性を実現。これにより、次世代基板に求められる低伝送損失・微細配線対応・歩留まり向上に貢献します。
ファインパターン対応
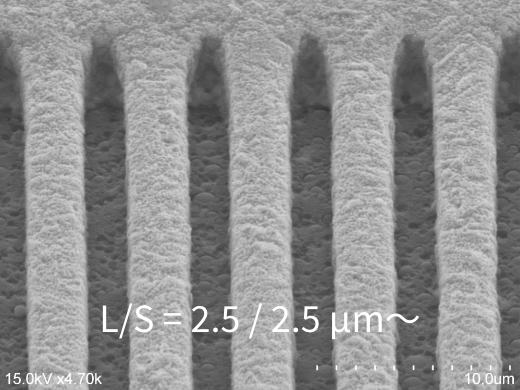
BUF: QX / SEKISUI CHEMICAL Co., Ltd.
DFR: DA Series / Asahi Kasei Corp.
Exposure: DI Exposure / ADTEC Engineering Co., Ltd.
高埋込性/ボイド抑制

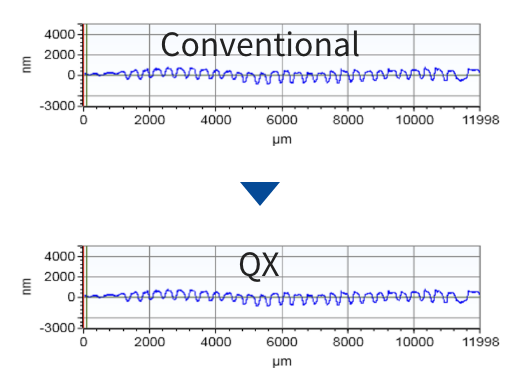
デラミ/基板反り抑制(低応力)

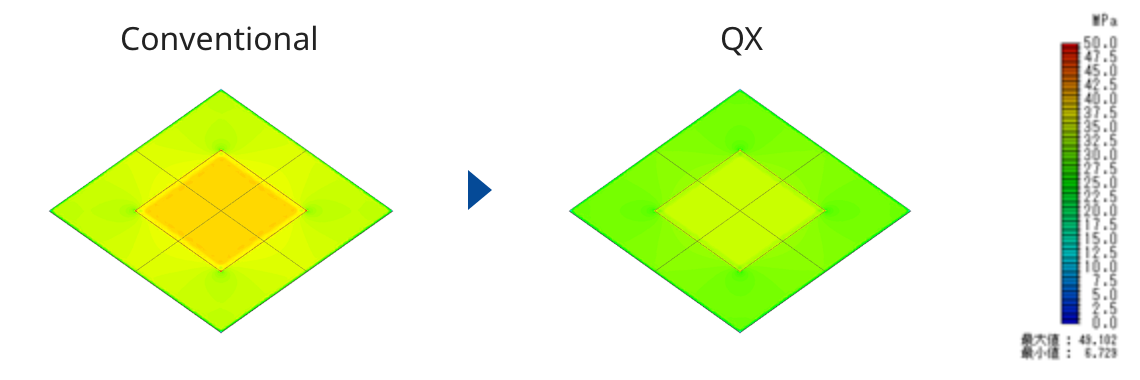
また、長年培ったテープ製造技術を活かし、多様な厚みに柔軟対応できるのも特長です。
通常、20-100umt (2.5um間隔) でご用意しておりますが、その他の厚みについてはお問合せください。

弊社ビルドアップフィルムのお客様(FC-BGAメーカー様)
製品ラインナップ
| For FCBGA | For Embedded | ||||||
|---|---|---|---|---|---|---|---|
| NX04H | NQ07XP | QX03 | EL | TC | HE | ||
| HVM | Sampling | Development | Development | ||||
| Df | @5.8GHz | 0.0090 | 0.0037 | 0.0023 | ≦0.0025 | 0.0084 | 0.0050 |
| Dk | @5.8GHz | 3.3 | 3.3 | 3.3 | ≦2.5 | 3.4 | 5 |
| CTE (25-150℃) | ppm/℃ | 24.5 | 27 | 17 | 17-23 | 13 | 20 |
| Tg (DMA) | ℃ | 205 | 183 | 183 | > 170 | 206 | 170 |
| Young’s Modulus | GPa | 8 | 10.4 | 13.1 | > 7 | 12.3 | 20 |
| Elongation | % | 2.4 | 2.6 | 2.9 | > 1.5 | 1.2 | 1.2 |
| Tensile Strength | MPa | 100 | 105 | 110 | > 70 | 102 | 90 |
| Thermal Conductivity | W/m K | 0.5 | 0.5 | 0.6 | > 0.3 | 0.6 | 2.0 |
用途例
積水化学のビルドアップフィルムは、最先端の通信・演算処理を行うICパッケージ基板に採用され、以下の分野で広く使用されています。

 AI処理
AI処理
モジュール- GPUやAIチップの高発熱・高密度配線要求に応える熱安定性・加工適性を備えています。
 データセンター用
データセンター用
サーバー- 優れた誘電特性と耐久性で、大量データ処理を支えるハイエンドサーバー回路の高信頼化に貢献します。
 イーサネット
イーサネット
スイッチ- 5G/クラウド社会を支える高速ネットワーク機器向けに、グローバルで高い採用実績を誇ります。
 高性能PC・
高性能PC・
ワークステーション- 複雑化・多層化する高性能PCにおいて、信号品質と製造効率を両立します。
使用プロセス
積水化学のビルドアップフィルムは、セミアディティブプロセス(SAP)に適合し、幅広いプロセスウィンドウで安定して使用可能です。
日本および台湾の複数の基板メーカー様および主要OSAT様での量産実績を有します。
セミアディティブプロセス(SAP)

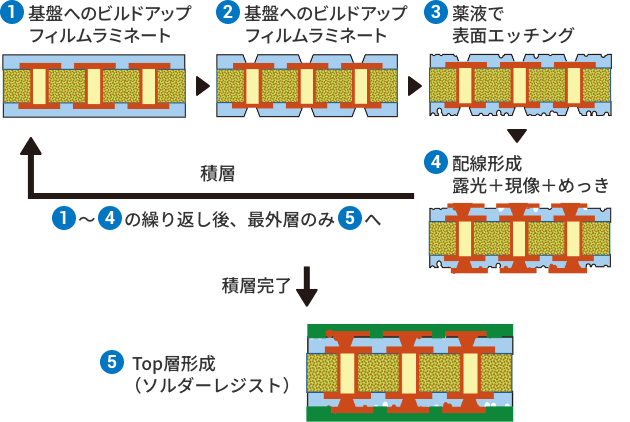
弊社ビルドアップフィルムの推奨SAP製造条件など製品に関する情報はお気軽にお問合せください。
ご相談ください
積水化学は、今後の高速通信に求められる各種技術課題のソリューションとなる新規ビルドアップフィルムの開発を行っています。
開発案件でご要望がある場合はお問い合わせください。
- ・ハイエンドサーバー回路の信頼性を高めたい
- ・新規ビルドアップフィルムの開発を依頼したい など
資料ダウンロード
- すべて
- エレクトロニクス
| 名称 | 種別 | 形式 | 更新日 | ファイル |
|---|---|---|---|---|
| カタログ 〈エレクトロニクス〉:熱硬化型層間絶縁フィルム | エレクトロニクス | 2025-09-30 | ダウンロード2.83 MB |

_エレクトロニクス画像2_png_w500px_h333px.png)