_熱硬化型層間絶縁フィルム_png_w500px_h333px.png)
열 경화형 층간 절연 필름
전자 디바이스의 미세 배선화, 고속 통신화에 기여 하는 빌드업 필름
- 일렉트로닉스
빌드업 필름이란(Build-up Film)
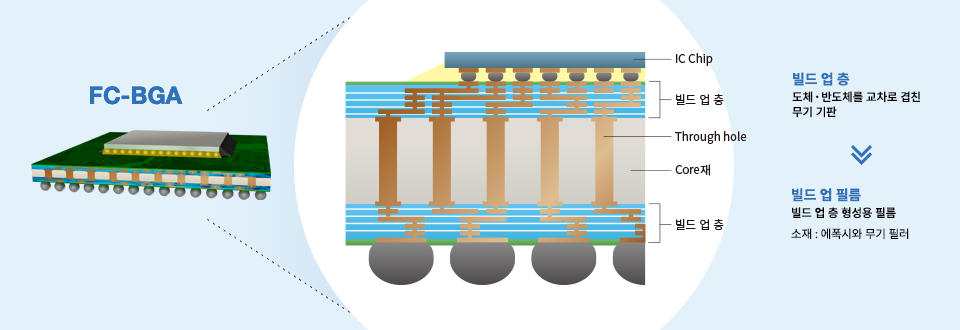
빌드업 필름은 첨단 IC 패키지 기판에서 미세 배선층을 형성하는 데 사용되는 층간 절연 재료 입니다. 전자 기기의 고속화에 따라 IC 패키지 기판 또한 속도 향상과 고성능화에 대응하기 위해 고밀도화가 진행되고 있으며, 미세 비아 형성 능력과 저유전 특성뿐만 아니라 가공 및 실장 시 뒤틀림을 억제하는 치수 안정성도 중요하게 여겨지고 있습니다. 이러한 첨단 IC 패키지 기판은 AI, 서버, 네트워크 장비 등 다양한 분야에서 채용이 확대되고 있으며, 빌드업 필름은 고성능·고신뢰 전자 디바이스 실현을 뒷받침하는 핵심 소재로 자리잡고 있습니다.
특징
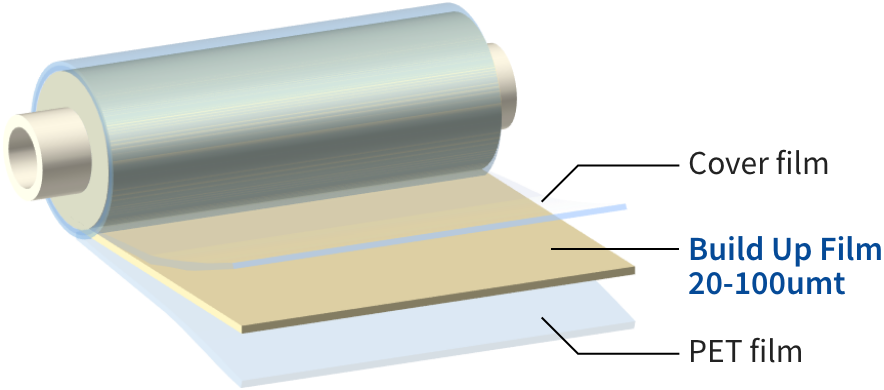
세키스이화학의 빌드업 필름은 우수한 전송 특성과 치수 안정성을 겸비하여, Multi layer·대형 하이엔드 IC 패키지 기판(FC-BGA) 에서 다수의 채용 실적을 가지고 있습니다.
저유전 및 저뒤틀림 특성을 통해 패키지 설계의 자유도를 높이고, 차세대 디바이스의 고성능화 및 고신뢰성 확보에 기여한다.
- 기판 뒤틀림
억제 - 낮은 전송 손실
- FLS(Fine Line Space) 구현
- 우수한
매립성
세키스이의 강점
세키스이화학의 빌드업 필름은 독자적인 배합 및 코팅 기술을 통해 저유전 손실(low Df), 디스미어(Desmear) 후 균일한 표면 거칠기, 높은 균열 저항성을 실현하였습니다. 이를 통해 저 전송 손실, 미세 배선 대응, 수율 향상 등 차세대 기판에 요구되는 성능 달성에 기여할 수 있습니다.
파인 패턴 대응
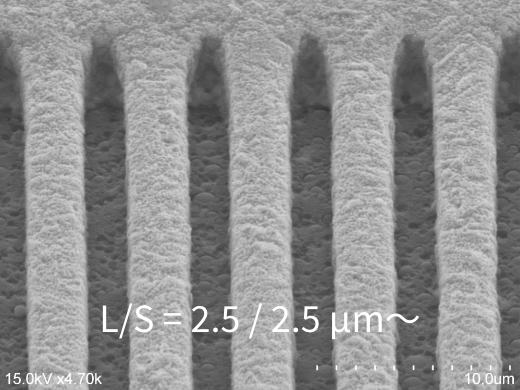
BUF: QX / SEKISUI CHEMICAL Co., Ltd.
DFR: DA Series / Asahi Kasei Corp.
Exposure: DI Exposure / ADTEC Engineering Co., Ltd.
높은 매립성·보이드 억제

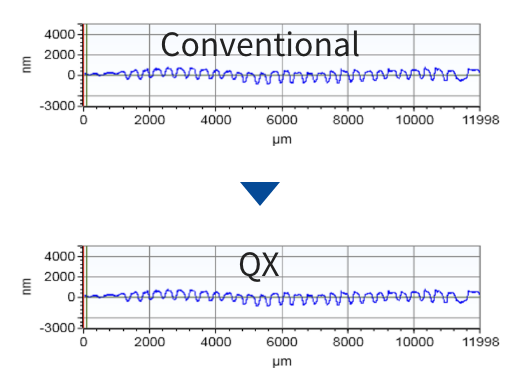
박리 및 기판 뒤틀림 억제(저응력 설계)

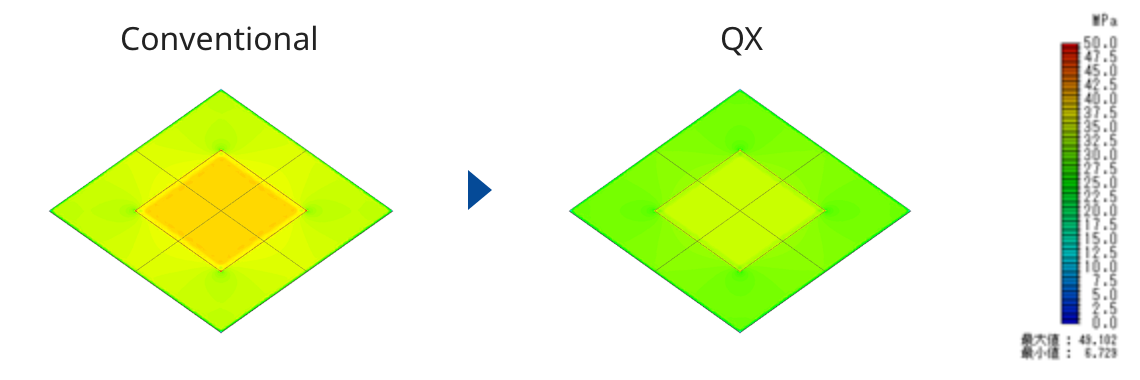
또한, 오랜 기간 축적된 폐사의 테이프 제조 기술을 활용하여 다양한 두께 사양에 유연하게 대응할 수 있습니다.
일반적으로 20~100 µm(2.5 µm 간격) 제품을 제공하지만, 그 외 두께에 대해서도 문의 주시면 검토가 가능합니다.

세키스이 빌드업 필름의 고객(FC-BGA메이커)
제품 라인업
| For FCBGA | For Embedded | ||||||
|---|---|---|---|---|---|---|---|
| NX04H | NQ07XP | QX03 | EL | TC | HE | ||
| HVM | Sampling | Development | Development | ||||
| Df | @5.8GHz | 0.0090 | 0.0037 | 0.0023 | ≦0.0025 | 0.0084 | 0.0050 |
| Dk | @5.8GHz | 3.3 | 3.3 | 3.3 | ≦2.5 | 3.4 | 5 |
| CTE (25-150℃) | ppm/℃ | 24.5 | 27 | 17 | 17-23 | 13 | 20 |
| Tg (DMA) | ℃ | 205 | 183 | 183 | > 170 | 206 | 170 |
| Young’s Modulus | GPa | 8 | 10.4 | 13.1 | > 7 | 12.3 | 20 |
| Elongation | % | 2.4 | 2.6 | 2.9 | > 1.5 | 1.2 | 1.2 |
| Tensile Strength | MPa | 100 | 105 | 110 | > 70 | 102 | 90 |
| Thermal Conductivity | W/m K | 0.5 | 0.5 | 0.6 | > 0.3 | 0.6 | 2.0 |
적용 분야
세키스이화학의 빌드업 필름은 첨단 통신 및 연산 처리를 수행하는 IC 패키지 기판에 적용되어, 다음과 같은 분야에서 폭넓게 사용되고 있습니다.

 AI 처리 모듈
AI 처리 모듈- GPU 및 AI 칩의 고발열·고밀도 배선 요구에 대응하는 열 안정성과 가공 적성을 보유하고 있습니다.
 데이터센터 서버
데이터센터 서버- 우수한 유전 특성 및 내구성으로 대용량 데이터 처리를 지원하는하이엔드 서버 회로의 신뢰성 향상에 기여합니다.
 이더넷 스위치
이더넷 스위치- 5G 및 클라우드 시대를 지탱하는 고속 네트워크 장비 분야에서 글로벌 수준의 높은 채용 실적을 자랑합니다.
 고성능 PC·워크스테이션
고성능 PC·워크스테이션- 복잡화·다층화되는 고성능 PC 환경에서 신호 품질과 제조 효율을 모두 실현합니다.
사용 프로세스
세키스이 화학의 빌드업 필름은 Semi Additive Process(SAP)에 적합하며, 폭넓은 Process window를 가지고 있어 안정적으로 사용할 수 있습니다.
일본과 대만의 다수 기판메이커 및 주요 OSAT에서의 양산 실적을 가지고 있습니다.
Semi Additive Process(SAP)

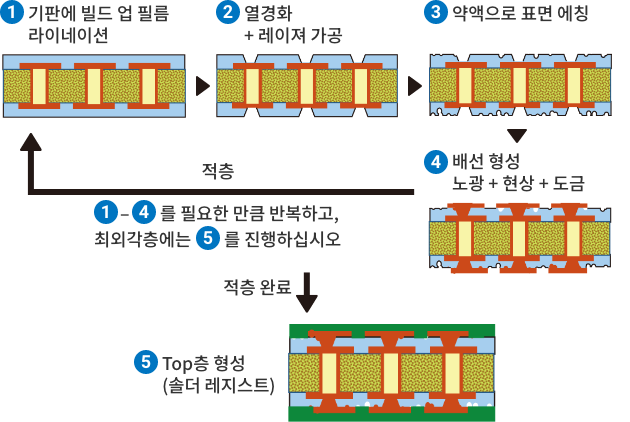
세키스이 빌드업 필름의 추천 SAP 제조조건 등 제품에 관한 정보가 필요하시다면 편하게 문의주십시오.
문의하기
세키스이화학은 향후 고속통신에서 요구되는 각종 기술과제의 솔루션이 되는 신규 빌드업필름의 개발을 하고 있습니다.
개발 안건으로 요청이 있으신 경우 문의를 부탁드립니다.
- ・하이엔드 서버 회로의 신뢰성을 향상시키고 싶은 경우
- ・신규 빌드업 필름 개발을 의뢰하고 싶은 경우 등

_エレクトロニクス画像2_png_w500px_h333px.png)