はんだ粒子入り異方性導電ペースト SACP

 -Challenge- 基板小型化・薄型化による実装難度UP
-Challenge- 基板小型化・薄型化による実装難度UP
パッケージ、PCBの高性能化、小型化、薄型化が進む中で、高速化を実現する低ギャップ化、高温高湿での高い信頼性の確保等実装時に要求される技術も高度化しています。
また、パッケージ、PCBの薄型化に伴い、従来の高温はんだ付け工法では高温による基板の反りの問題がより顕在化してきています。
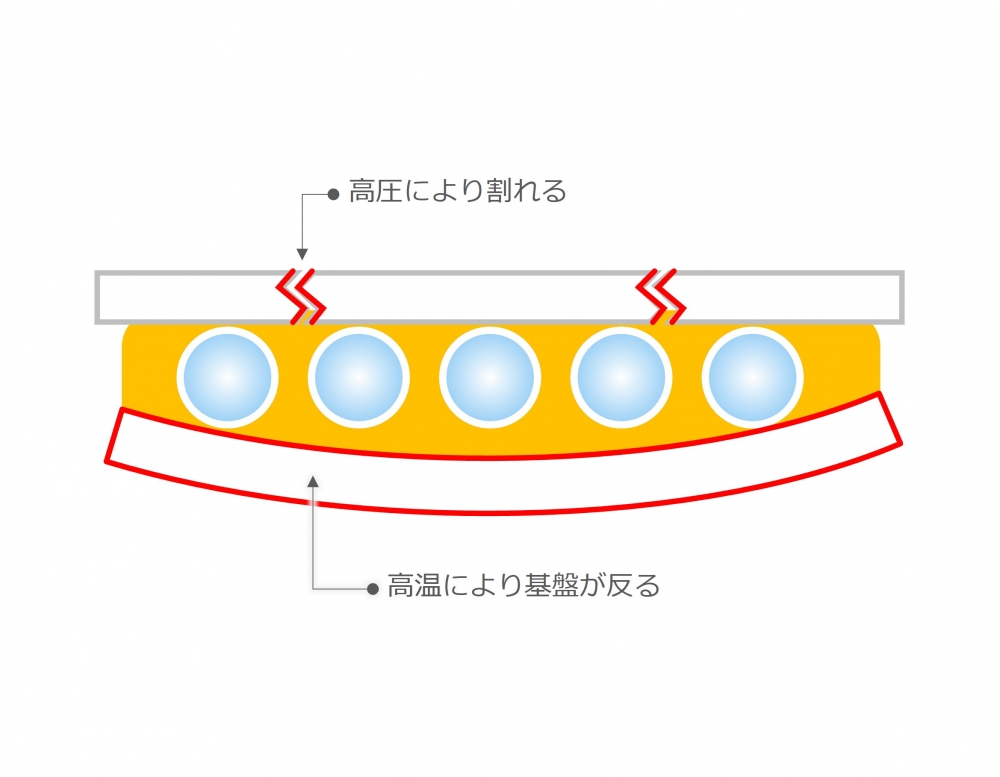
 -Solution- 低温・低圧金属接合
-Solution- 低温・低圧金属接合
「はんだ粒子入り異方性導電ペースト SACP」は、低温低圧で金属接合が可能な異方導電ペーストです。
低圧・低温のボンディングプロセス(約1MPa,140℃×10秒)で金属接続を実現します。
高温高湿の環境下でも、高い信頼性を維持します。
低背接続(0.1mm厚以下)、ファインピッチ接続(150um)が可能です。
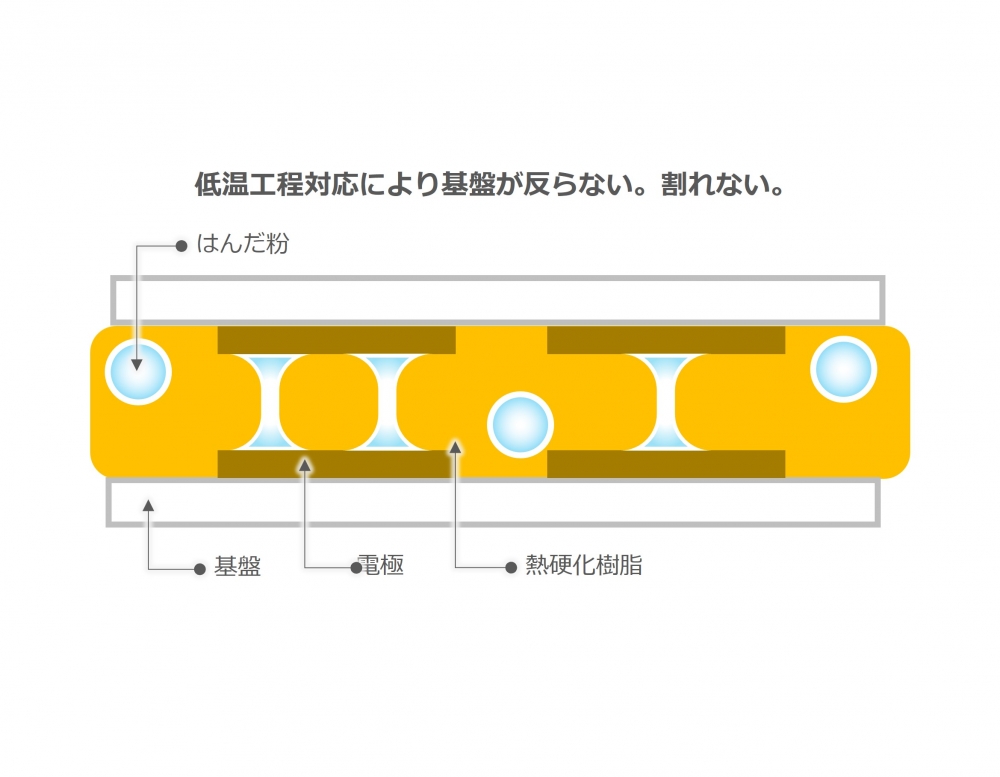
 -Technology- 技術情報
-Technology- 技術情報
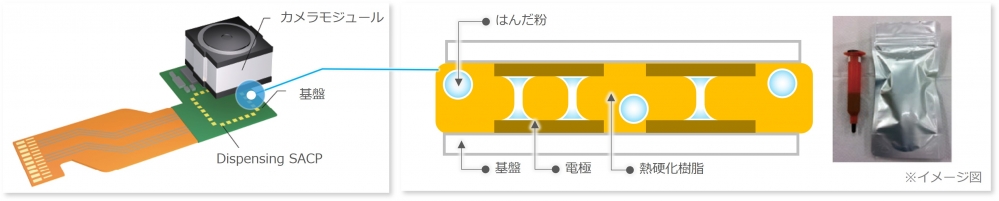
技術概要
 低温低圧実装が可能
低温低圧実装が可能
圧力1MPa 140度×10秒で 実装が可能

 高い信頼性性能
高い信頼性性能
高温高湿環境下においても
高い信頼性性能を維持

技術詳細
 低温低圧実装が可能
低温低圧実装が可能
推奨熱圧着条件
圧力 1~3MPa温度 ピーク140℃以上
熱圧着時間 10秒以上
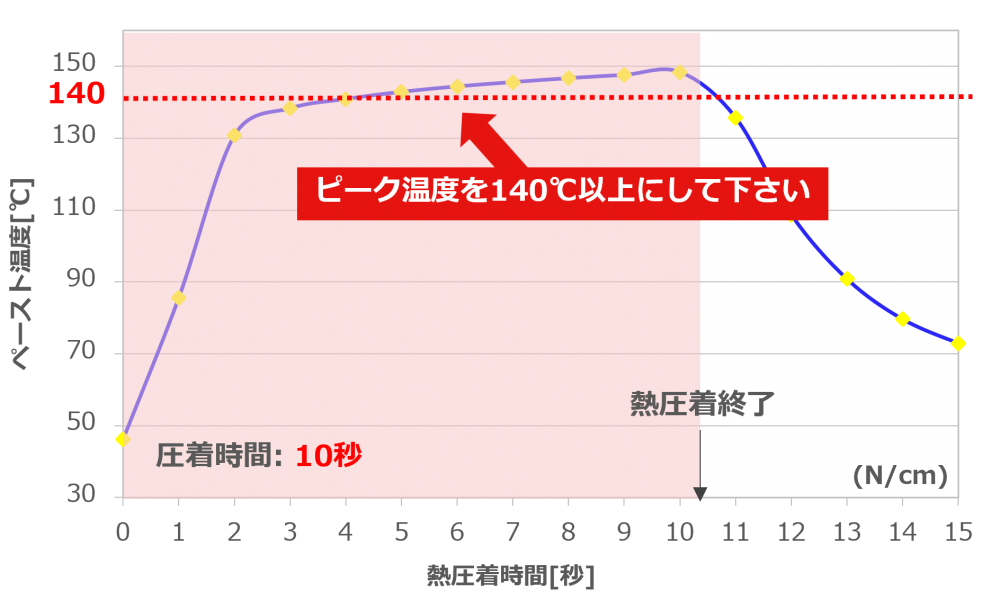
 高い信頼性性能
高い信頼性性能
1, 85℃85%試験後の抵抗値測定

2, 85℃85%試験後の接着力測定



 モビリティ
モビリティ
